Filter articles
标签
产品
Loading...
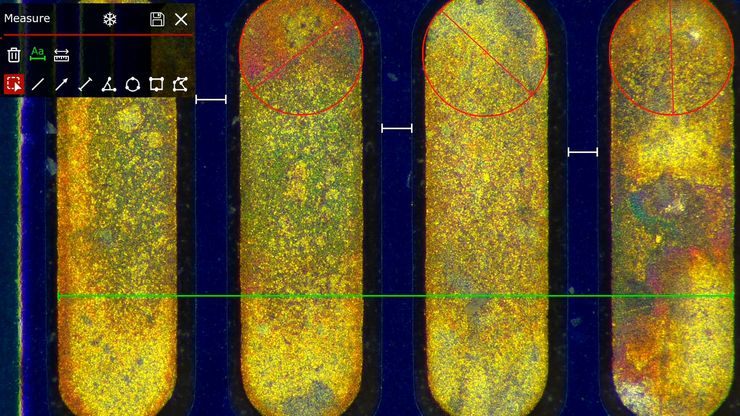
如何选择合适的测量显微镜
使用测量显微镜,用户可以测量样品特征的二维和三维尺寸,这对检测、质量控制、故障分析和研发&D 至关重要。然而,选择合适的显微镜需要评估应用需求以及显微镜的性能、易用性和灵活性。 如今,测量通常以数字方式进行,即使用带有摄像头和软件的显微镜,图像显示在显示器上,而不是通过目镜网线,从而提高了精度和可重复性。使用合适的测量显微镜可靠、快速地分析样品。
Loading...

显微镜测量校准:为什么要校准以及如何校准
显微镜校准可确保用于检测、质量控制 (QC)、故障分析和研发 (R&D) 的测量结果准确一致。本文介绍了校准步骤。使用参照物进行校准可获得可重复的结果,并有助于确保与准则和标准一致。为获得准确一致的结果,建议校准显微镜并定期检查。如有需要,可向校准专家寻求支持。
Loading...

晶圆表面光刻胶残留与有机污染物可视化检测
随着半导体集成电路 (IC) 的尺寸缩小到 10 纳米以下,在晶圆检测过程中有效检测光刻胶残留物等有机污染物和缺陷变得越来越重要。光学显微镜仍是常用的检测方法,但对于有机污染而言,明视野和其他类型的照明都有其局限性。本文讨论了在半导体行业的质量控制、故障分析和研发&D 过程中,如何利用荧光显微镜有效检测晶片上的光刻胶残留物和其他有机污染物。
Loading...

Rapidly Visualizing Magnetic Domains in Steel with Kerr Microscopy
The rotation of polarized light after interaction with magnetic domains in a material, known as the Kerr effect, enables the investigation of magnetized samples with Kerr microscopy. It allows rapid…
Loading...

6 英寸晶片检测显微镜,可靠的观察微小高度差
本文介绍了一种 6 英寸晶圆检测显微镜,无论用户的技术水平如何,它都能自动进行可重复的 DIC(微分干涉对比)成像。集成电路 (IC) 芯片和半导体元件的制造需要晶圆检测,以确保不存在影响性能的缺陷。通常使用光学显微镜进行质量控制、故障分析和 R&D 检测。为了有效地观察晶圆上结构之间的微小高度差,可以使用 DIC。
Loading...

高效清洁度分析的关键因素
在汽车和电子行业,零部件上细小的污染颗粒物也可能影响产品的性能,导致产品出现故障,或使用寿命缩短。对于汽车来说,过滤系统很容易受到影响。对于电子产品来说,印刷电路板(PCB)或连接器上的污染可能会导致短路。因此,清洁度在现代制造业的质量控制中占有核心地位,特别是使用由不同供应商生产的部件时,更要重点关注清洁情况。车辆或设备的关键部件如果受到污染,整个系统就可能发生故障。因此,高效清洁度分析过程必须…
Loading...

横截面切片法分析IC芯片的结构与化学成分
从本文中了解如何通过横截面分析法对集成电路 (IC) 芯片等电子元件进行有效的结构和元素分析。探索如何通过研磨系统进行铣削、锯切、磨削和抛光工艺以及用于同时进行目视检测和化学分析的二合一解决方案来完成的。可针对电子行业的各种工作流程和应用实现快速、详细的材料分析,包括竞争分析、质量控制 (QC)、故障分析 (FA) 以及研发 (R&D)。
Loading...
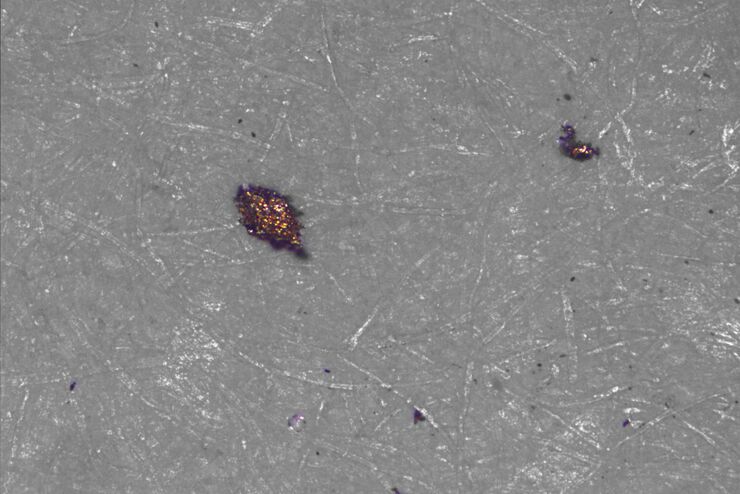
选择清洁度分析解决方案需考虑的因素
正确的清洁度分析解决方案对质量控制至关重要。本文介绍了选择适合自身需求的解决方案时应考虑的一些重要因素。这些因素取决于不同的方面,例如:(微电子或汽车)行业,污染物类型、尺寸、成分、材料属性和可能造成的损害等。从基本的清洁度验证到更复杂的分析,有多种基于显微镜和激光光谱的清洁度解决方案可供选择。


