介绍
金属合金、汽车、航空航天、运输和电子等行业的产品和应用,以及金相学、地球科学和材料科学等领域都离不开材料分析[1]。面对日益激烈的竞争和日益严苛的国际、区域或组织标准,市场必须选择经济高效的方式来保障产品的质量或研究结果的可靠性,以进行后续创新。
采用多种技术对材料进行目视检查,然后确定其局部成分的方法,需耗费大量的时间和成本[1]。按照一般的工作流程,首先是使用具备不同放大倍率和对比技术的光学显微镜检测样本。然后通过定性化学/元素光谱分析确定样本成分。对于具体的应用,通常要先了解材料的微观结构和成分的可靠数据,然后再决定进一步的行动。如果时间和预算有限,迫使人们必须采取有效的方法来迅速做出正确决策时,快速获取这些数据就显得尤其重要了。
在一些检测中,如质量控制(QC)和故障分析(FA),还需要确定污染物并了解其对基材的影响。例如,电子行业(印刷电路板上的钎焊和电子引线)、汽车/运输行业和建筑(金属板)行业[2-4]。
下文中介绍了如何使用一种二合一解决方案高效分析污染物和底层基材,即来自徕卡显微系统的DM6 M LIBS材料分析系统。
污染物和基材分析
LIBS方法通过激光烧蚀钻孔至污染层中和下方,抵达基材底层。 通过微钻孔,可以清洁表面,即清除污染物,并将基材暴露在外。同时还可以研究污染物对基材的影响。图1为在铜合金上进行微钻孔的示例。
电子行业应用
检测表面污染物的影响
使用DM6 M LIBS二合一解决方案检测USB驱动连接器(表面镀银的铜[Cu]合金)。组件上存在污染物(灰色圆圈部分,图2A)。电子组件的饰面有严格的质量标准规定。生产过程或当地环境造成的表面污染会导致产品质量下降,甚至造成故障。
检测目的是确定仅组件表面(图2b)存在污染,还是污染物已经损坏了组件下面的银金属层(图2C)。
目录
检测组件或部件时,例如印刷电路板(电子)或车辆金属板(汽车和运输)上的钎焊和引线,了解污染物的影响非常重要。2合1解决方案可以大幅节省材料分析的成本和时间。
在生产、质量控制、故障分析或研发过程中,如果材料数据足够相关、准确、可靠,那么决策者就能更快、更有信心地作出决策。
目视检查后,发现连接器上存在污染区域,如图2A所示。为进一步查看详细情况,使用徕卡显微系统DM6 M 显微镜在五倍物镜放大率下对目标区域(灰色圆圈标注的部分)。
检测过程中,使用了不同的对比方法,以确定污染物的形状和颜色。在明场模式下,发现了单点和其它异常区域(图3A)。在暗场模式下,可以看到不同的颜色(图3B)。
因此,通过视觉检测,可以检测到污染物表面,但却无法看到污染物接触面和银金属层的状况。
使用LIBS,可以分析污染物,然后通过激光烧蚀清除。使用激光多次冲击相同位置,可以获得底层材料的化学信号。根据具体的材料,每次冲击可以在直径大约15微米的区域烧蚀2-5微米深。
通过在未污染表面(图2A中的白色X部分)使用LIBS,可以获得一个参考信号,光谱(图4A)中会出现不同的发射峰。将标准光谱与参考信号进行对比,可以发现存在的元素,例如铜和银(图4B)。
污染物分析
在污染区的相同点施加了不超过3次激光冲击,以进行LIBS测量。对材料层进行微钻孔所需的冲击次数在很大程度上取决于层厚和材料硬度。
在第一个光谱中,在430nm和590nm处可以看到两个显著的信号。将这些信号与元素参考光谱[5]进行对比,可以确定是钙(Ca)和钠(Na)(图5)。
由于在第一个光谱(图6A)中仅看到了钙和钠的信号,激光烧蚀尚未触及底层的银和铜。比较第一次激光冲击(图6A)和第二次冲击(图6B)记录的光谱,可以看出,第二次冲击后,光谱中出现了铜和银的发射峰。在进一步的分析中,铜和银信号的强度持续增强。
小结
本报告介绍了一种使用徕卡显微系统的二合一解决方案DM6 M LIBS材料分析系统分析USB连接器污染物和底层基材的高效工作流程。
在很多种产品开发(研发)、检测鉴定(IQ)、质量控制(QC)、失效分析(FA)和技术应用中,材料分析都十分重要。它是多个行业和领域中使用的常规方法。尽管为这种分析所分配的时间和费用通常有限,但始终要获得可靠的结果和预期的产品质量。
对于组件的检测、QC或FA,需要识别污染物并了解其对基材的影响。例如,印刷电路板上的钎焊和电子引线。
本文中所示的显微镜和LIBS数据表明,污染物层相对较薄,未对USB连接器的基材造成氧化或腐蚀等显著的不可逆影响。
相关文章
-
![[Translate to chinese:] Particulate contamination in between moving metal plates. [Translate to chinese:] Particulate contamination in between moving metal plates.](/fileadmin/_processed_/b/d/csm_Particulate_contamination_in_between_moving_metal_plates_2_61b4c1c546.jpg)
高效清洁度分析的关键因素
在汽车和电子行业,零部件上细小的污染颗粒物也可能影响产品的性能,导致产品出现故障,或使用寿命缩短。对于汽车来说,过滤系统很容易受到影响。对于电子产品来说,印刷电路板(PCB)或连接器上的污染可能会导致…
Jan 03, 2024Read article
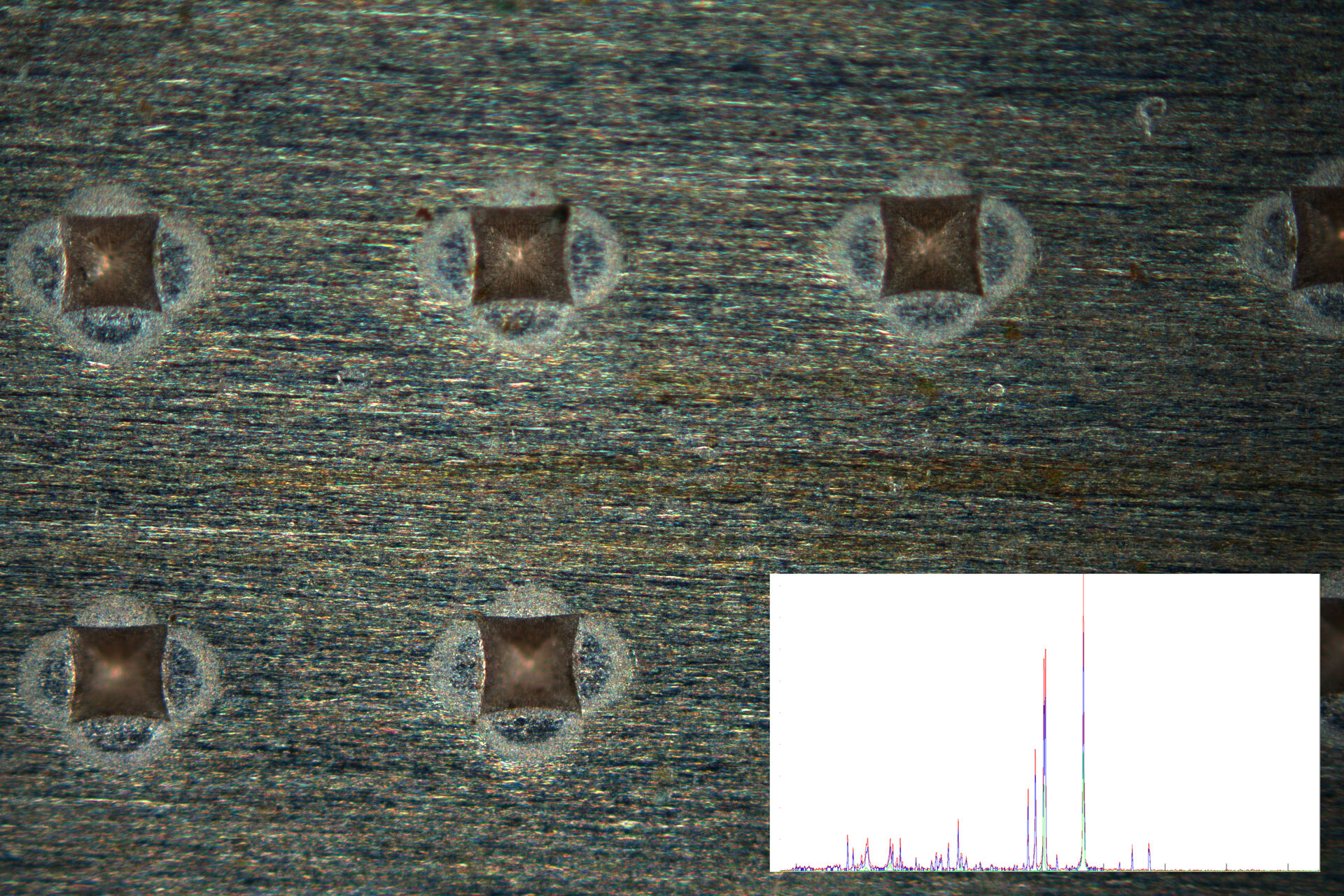
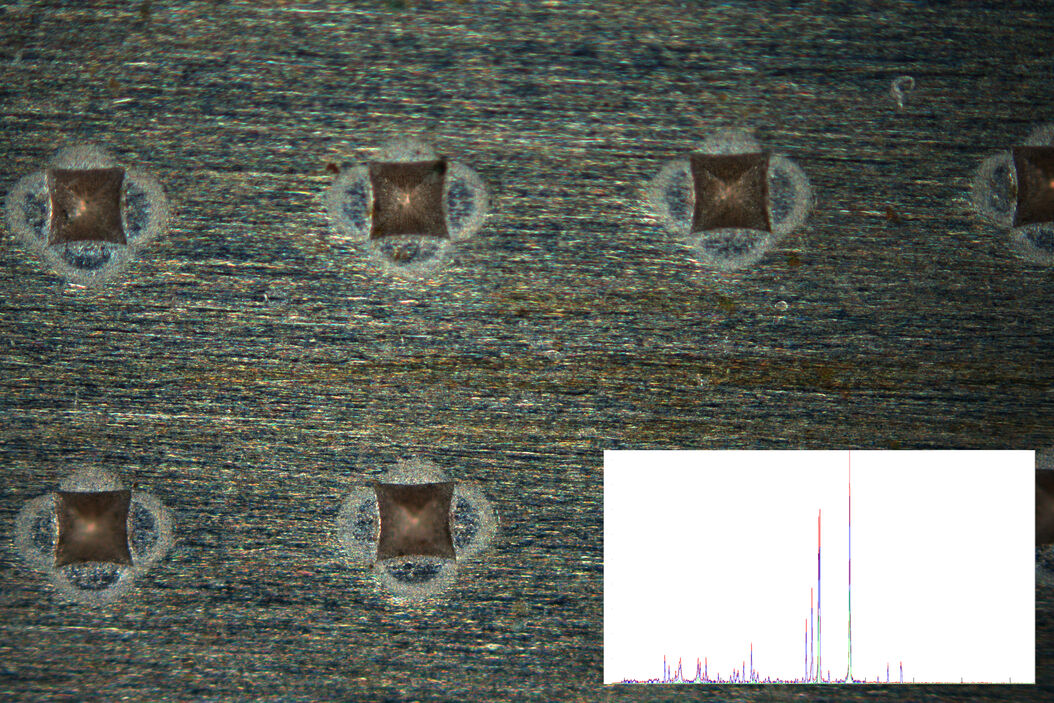


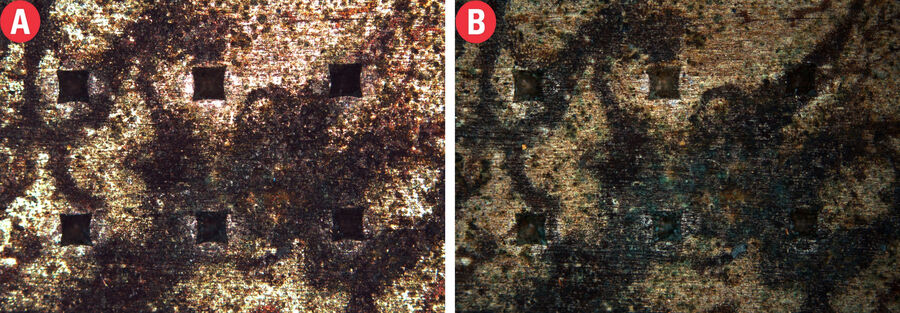
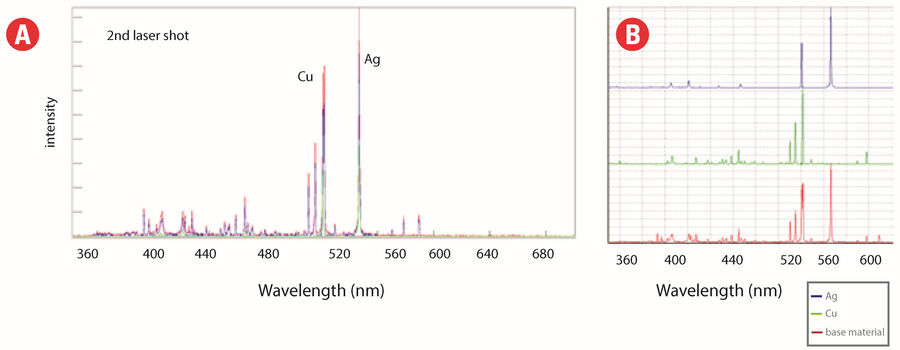


![[Translate to chinese:] Image of an integrated-circuit (IC) chip cross section acquired at higher magnification showing a region of interest. [Translate to chinese:] Image of an integrated-circuit (IC) chip cross section acquired at higher magnification showing a region of interest.](/fileadmin/_processed_/a/c/csm_IC_chip_cross_section_b2bf8f2497.jpg)
![[Translate to chinese:] Optical microscope image of salt contamination on an aluminum/silicon (Al/Si) surface. Credit: Gerweck GmbH, Germany. [Translate to chinese:] Optical microscope image of salt contamination on an aluminum/silicon (Al/Si) surface. Credit: Gerweck GmbH, Germany.](/fileadmin/_processed_/0/5/csm_Electroplating_LIBS_on-dema_96d3461bc7.jpg)
